没有合适的资源?快使用搜索试试~ 我知道了~
PCB技术中的基于满足更小尺寸需求的制程技术
需积分: 0 0 下载量 36 浏览量
2020-12-06
08:49:47
上传
评论
收藏 115KB PDF 举报
温馨提示

试读
2页
随着便携式电子产品变得越来越小、越来越轻薄,制程技术也不断创新。本文将介绍的用于智能卡的FCOS封装、VIP50工艺和芯片级封装(CSP)不但满足了更小的元器件尺寸需求,而且能够实现更好的产品性能。 能满足第三代智能卡尺寸要求的FCOS封装 英飞凌公司与德国智能卡制造商Giesecke & Devrient推出的用于智能卡的FCOS封装可满足新型第三代智能卡(UICC)对尺寸的要求。FCOS模块的厚度不大于500μm,整个模块的金触点位于芯片卡的左侧。 FCOS封装(上)与金线焊接(下)的对比 FCOS模块中芯片的功能衬面直接通过导电触点与模块连接,不再需
资源详情
资源评论
资源推荐
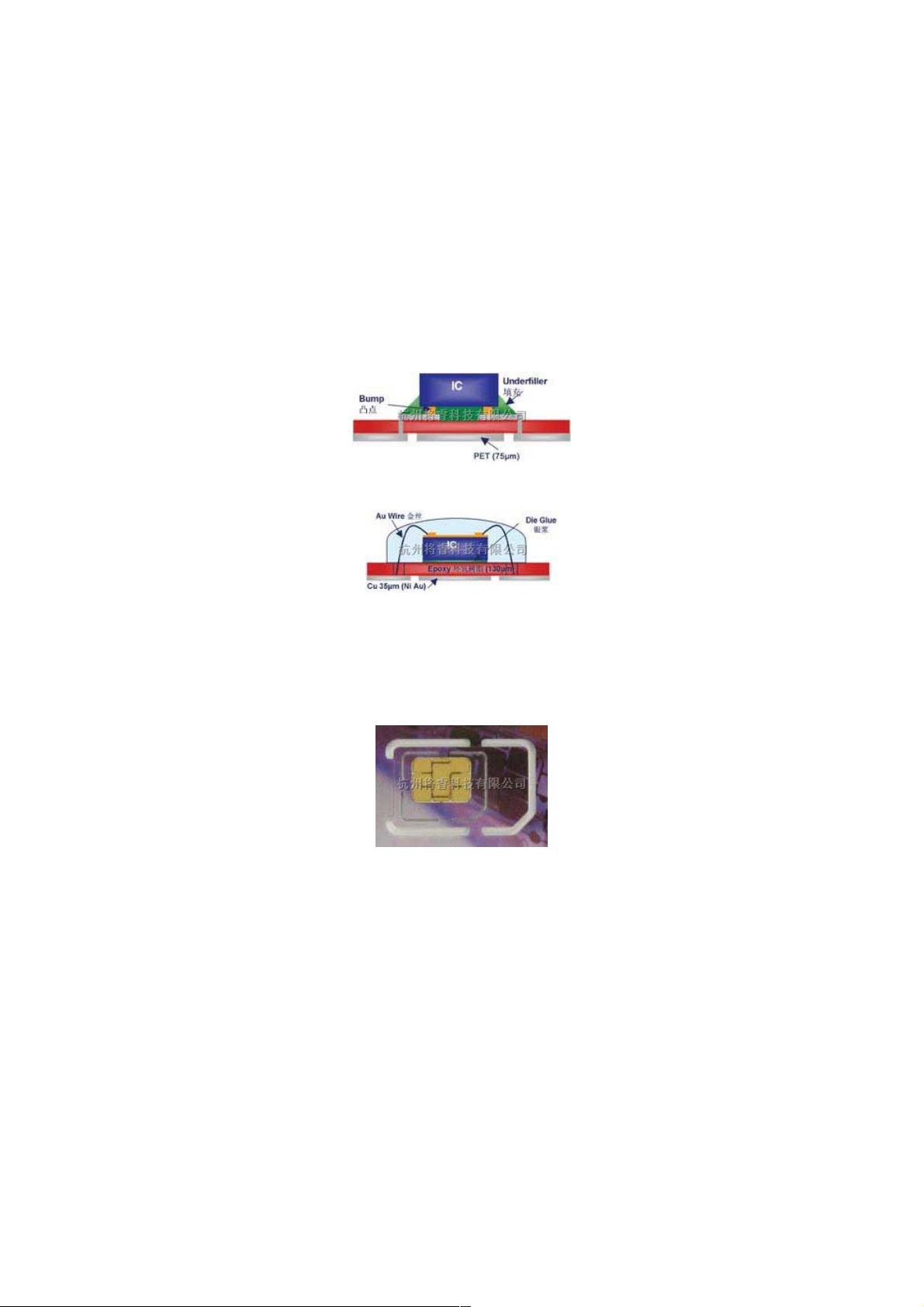
PCB技术中的基于满足更小尺寸需求的制程技术技术中的基于满足更小尺寸需求的制程技术
随着便携式电子产品变得越来越小、越来越轻薄,制程技术也不断创新。本文将介绍的用于智能卡的FCOS封
装、VIP50工艺和芯片级封装(CSP)不但满足了更小的元器件尺寸需求,而且能够实现更好的产品性能。
能满足第三代智能卡尺寸要求的FCOS封装 英飞凌公司与德国智能卡制造商Giesecke & Devrient推出的
用于智能卡的FCOS封装可满足新型第三代智能卡(UICC)对尺寸的要求。FCOS模块的厚度不大于500μm,
整个模块的金触点位于芯片卡的左侧。 FCOS封装(上)与金线焊接(下)的对比 FCOS模块中芯片
的功能衬面直接通过导电触点与模块连接,不再需
随着便携式电子产品变得越来越小、越来越轻薄,制程技术也不断创新。本文将介绍的用于智能卡的FCOS封装、VIP50
工艺和芯片级封装(CSP)不但满足了更小的元器件尺寸需求,而且能够实现更好的产品性能。
能满足第三代智能卡尺寸要求的 能满足第三代智能卡尺寸要求的FCOS封装封装
英飞凌公司与德国智能卡制造商Giesecke & Devrient推出的用于智能卡的FCOS封装可满足新型第三代智能卡(UICC)
对尺寸的要求。FCOS模块的厚度不大于500μm,整个模块的金触点位于芯片卡的左侧。
FCOS封装(上)与金线焊接(下)的对比
FCOS模块中芯片的功能衬面直接通过导电触点与模块连接,不再需要传统的金丝和合成树脂封装。由于封装中省去了金
属线,大大节约了模块空间,一方面可以在模块尺寸不变的情况下安置更大的芯片,使芯片卡具有更多的功能;另一方面也可
以使芯片卡的模块尺寸更小。此外,与传统的金线焊接(bonding)技术相比,采用FCOS的芯片卡具有更强的机械稳定性和
光学视觉效果、更小和更薄的模块尺寸、更强的防腐性和韧性,并且采用了非卤素材料,符合RoHS指令。
第三代智能卡的尺寸是目前SIM卡的一半
欧洲电信标准组织(ETSI)已决定在手机中使用更小尺寸的智能卡,新型第三代智能卡可应用于超薄移动电话、手持读卡器
和其他终端设备。今后SIM卡的尺寸只有12mm×15mm,这要需更小的芯片卡模块,而FCOS正好能满足这一需求。
使放大器性能更高、尺寸更小的 使放大器性能更高、尺寸更小的VIP50工艺工艺
VIP50工艺是美国国家半导体独有的绝缘硅(SOI)BiCMOS工艺,适用于放大器芯片的生产。该工艺采用的薄膜电阻不
但有微调功能,还具有极高的准确度,令其在很多方面都优于传统的双极或CMOS工艺。
所有VIP50的晶体管都装设于绝缘硅(SOI)圆片之上,然后以沟道互相隔离。这种隔离设计可将寄生电容减至最少,并
大幅提高放大器的带宽功率比。隔离的另一优点是即使信号电压高于供电干线电压,芯片内的晶体管仍可调节有关的信号。此
外,由于SOI技术可以防止漏电情况出现,即使在工厂及汽车内等极高温度的环境下操作,也不会对放大器的性能产生任何不
利的影响。
哈哈碰碰车
- 粉丝: 159
- 资源: 932
上传资源 快速赚钱
 我的内容管理
展开
我的内容管理
展开
 我的资源
快来上传第一个资源
我的资源
快来上传第一个资源
 我的收益 登录查看自己的收益
我的收益 登录查看自己的收益 我的积分
登录查看自己的积分
我的积分
登录查看自己的积分
 我的C币
登录后查看C币余额
我的C币
登录后查看C币余额
 我的收藏
我的收藏  我的下载
我的下载  下载帮助
下载帮助

 前往需求广场,查看用户热搜
前往需求广场,查看用户热搜安全验证
文档复制为VIP权益,开通VIP直接复制
 信息提交成功
信息提交成功

评论0