jfkj2021
- 粉丝: 88
- 资源: 158
最新资源
- MATLAB机器人运动学正逆解、动力学建模仿真与轨迹规划,雅克比矩阵求解.蒙特卡洛采样画出末端执行器工作空间 基于时间最优的改进粒子群优化算法机械臂轨迹规划设计 圆弧轨迹规划 机械臂绘制写字
- simulink 光伏MPPT模型 光伏遮荫时扰动观察法和粒子群MPPT的结果对比 图1为模型 图2为光伏遮荫时I-U曲线 图3为光伏遮荫时P-U曲线 图4为两种算法结果对比 图5为粒子群的仿真结果显
- HarmonyOS Next 抓取设备日志信息脚本
- FPGA运动目标检测仿真代码 硬件:正点原子达芬奇 新起点 软件:Vivado quartus 内容:ov5640配置和数据输出,rgb2ycbcr,帧差,腐蚀,膨胀,边框检测,加边框,hdm
- CATIA DMU转向系统运动仿真(可编辑,无参数) 悬架是麦弗逊式独立悬架 左右车轮相互独立,可单独上跳和下跳 转向系统齿轮齿条转向器,实现左右转向功能
- 铁木辛柯梁振动分析仿真 COMSOL案例还原及 此模型研究深梁的自由振动和强迫振动,使用铁木辛柯梁计算了特征频率、频率响应和瞬态分析的解
- 电动汽车三相车载充电机(OBC)模拟仿真 图一整体电路与控制图 图二直流母线电压曲线 图三有功无功曲线 图四电池参数曲线 图5进入逆变器端电流跟随电压曲线
- 博途S7-1200与台达伺服控制器RS485通讯 1.提供 2.提供源程序
- 小波时频图 cnn卷积分类
- 基于MATLAB的口罩佩戴检测系统
- 三相光伏储能并网NPC逆变器采用MPPT,中点电压平衡svpwm控制 图一整体结构电路与控制曲线 图二电流锁电网电压并随着发电功率变化而变化 图三,电流电压曲线放大图 图四 五点平NPC线电压曲线 图
- 模型预测控制的LCL型三相并网逆变器控制方法,FCS-MPC+并网电流控制+中点电压控制+SOGI 并附带参考文献,内容详实,适合电力电子入门仿真参考
- 计算机网络开发实战基础教程
- FPGA verilog实现图像SAD算法配置计算及AHB接口数据传输交互 具备3种窗口配置,包含计算、储存及AHB接口数据交互和状态查询功能
- maxwell电机电磁仿真 开关磁阻电机 电力磁双凸极电机 磁通切电机设计,仿真,分析
- 基于yolov7的海上船舶检测和识别(含源码和数据集) 总共六个类别:ore carrier,passenger ship,container ship,bulk cargo carrier,gene
资源上传下载、课程学习等过程中有任何疑问或建议,欢迎提出宝贵意见哦~我们会及时处理!
点击此处反馈




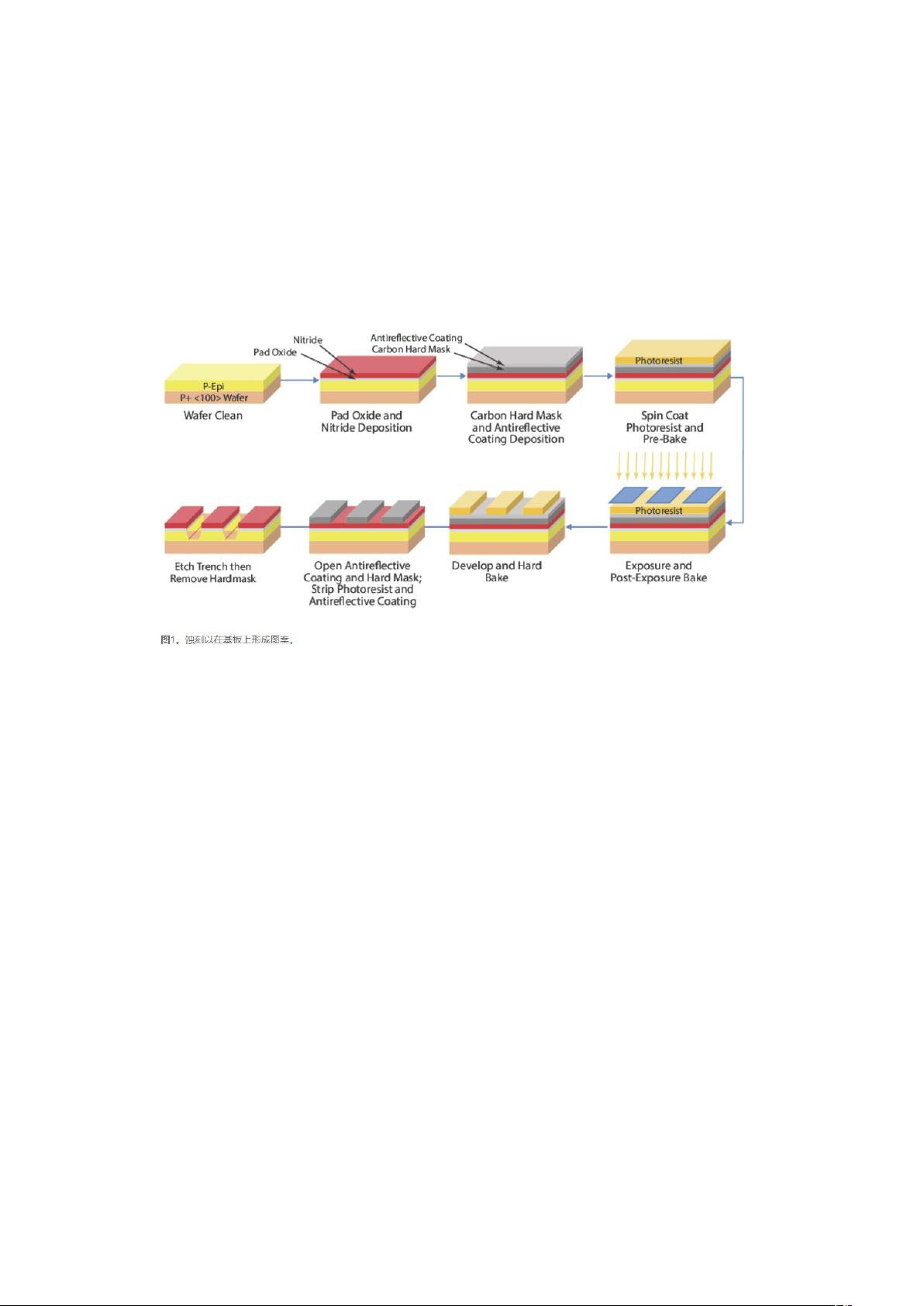










评论0