没有合适的资源?快使用搜索试试~ 我知道了~
资源推荐
资源详情
资源评论

Bumping Technology
Introduction
Prepare By: Mady Wang
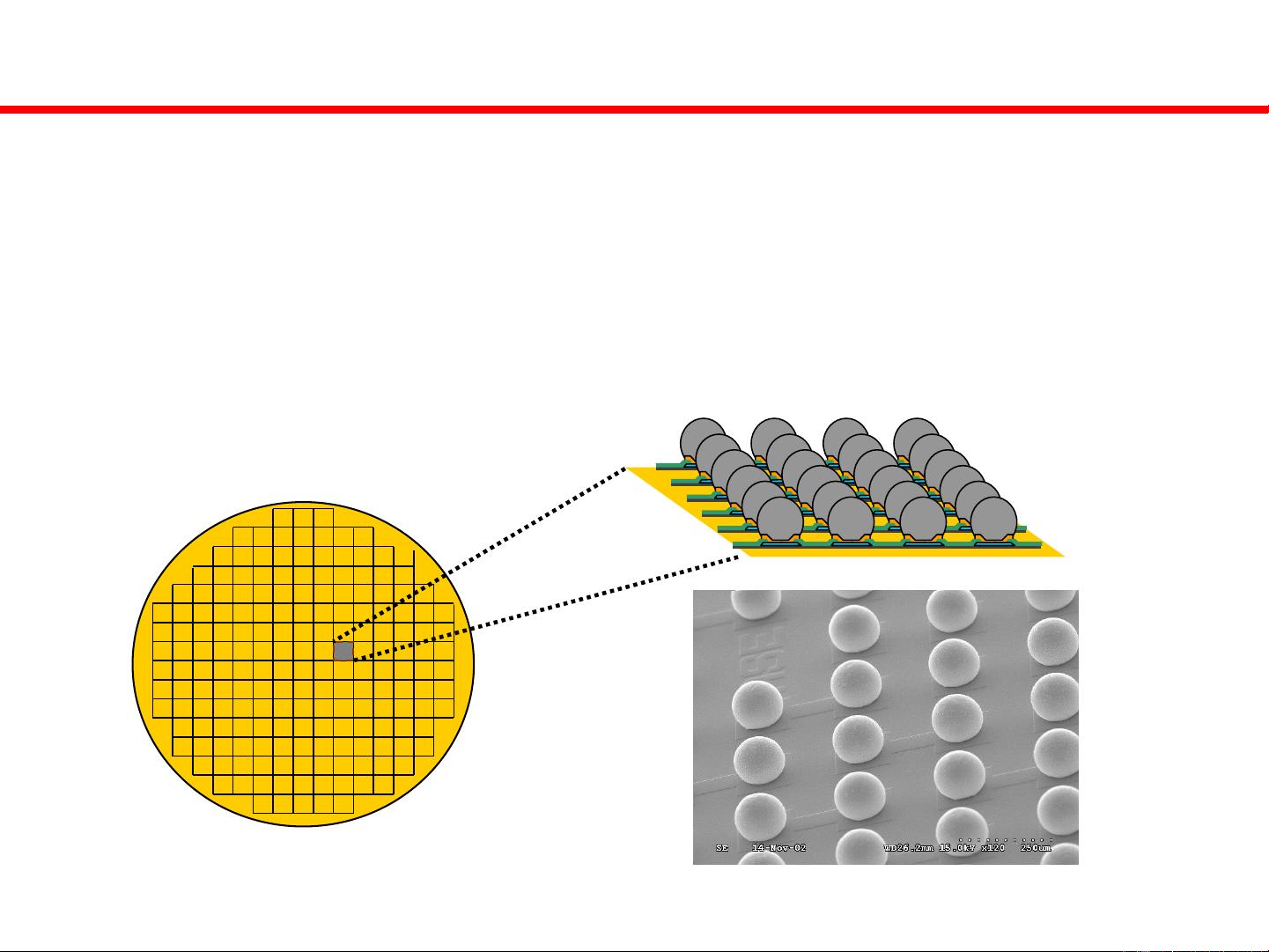
What is Bumping?
• To generate bumps on wafer.
• The essence to advanced packaging, specifically
flip chip packaging.
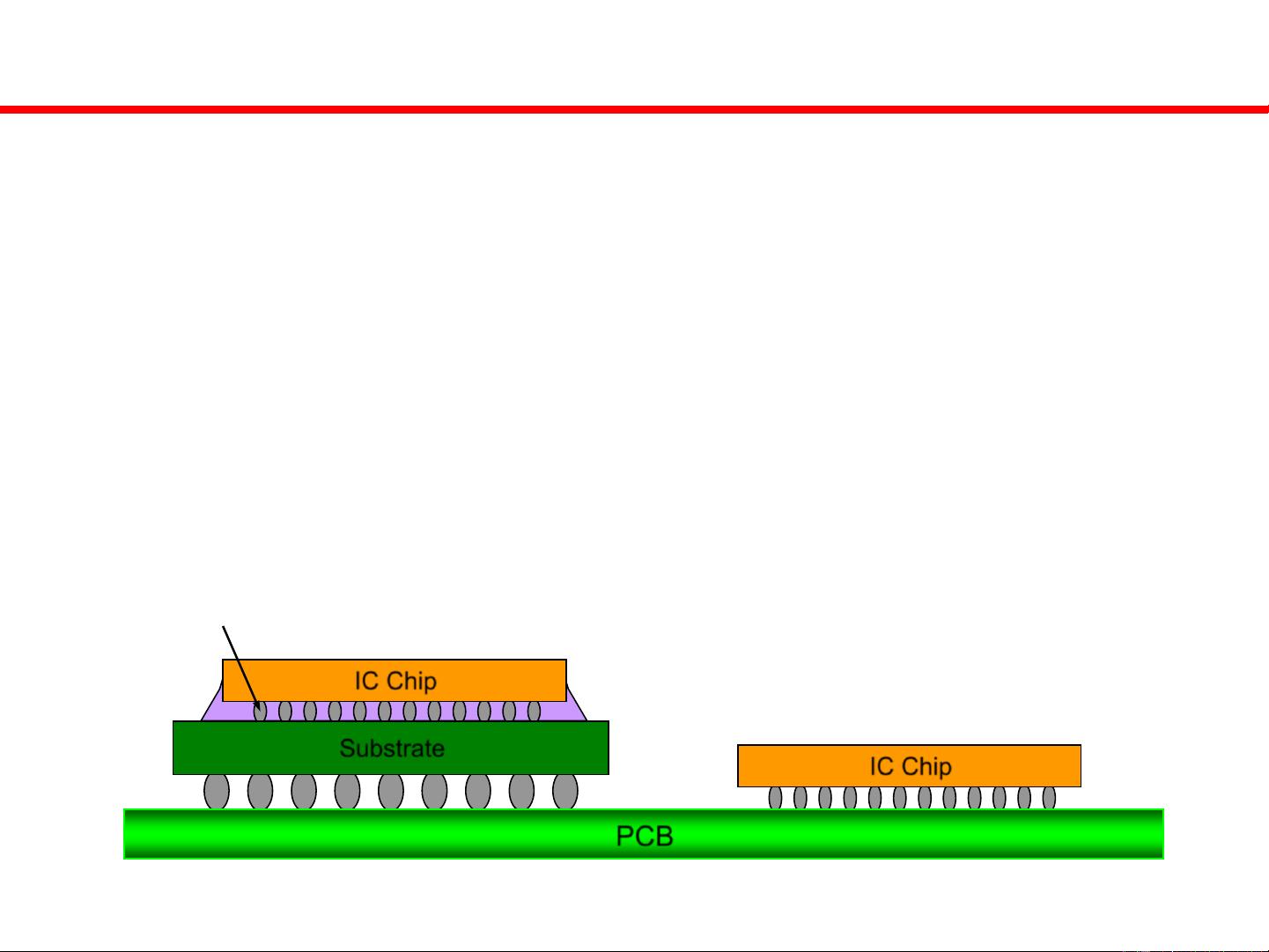
Benefits of bumping?
• High density interconnection.
• High speed data processing (short connection path, lower
connection resistance and higher driving current density)
• Small package body size.
• Real chip size achievable.
• Cost competitive.
Flip Chip in Package(FCIP) Flip Chip on Board(FCOB)
IC Chip
Substrate
IC Chip
PCB
Bump
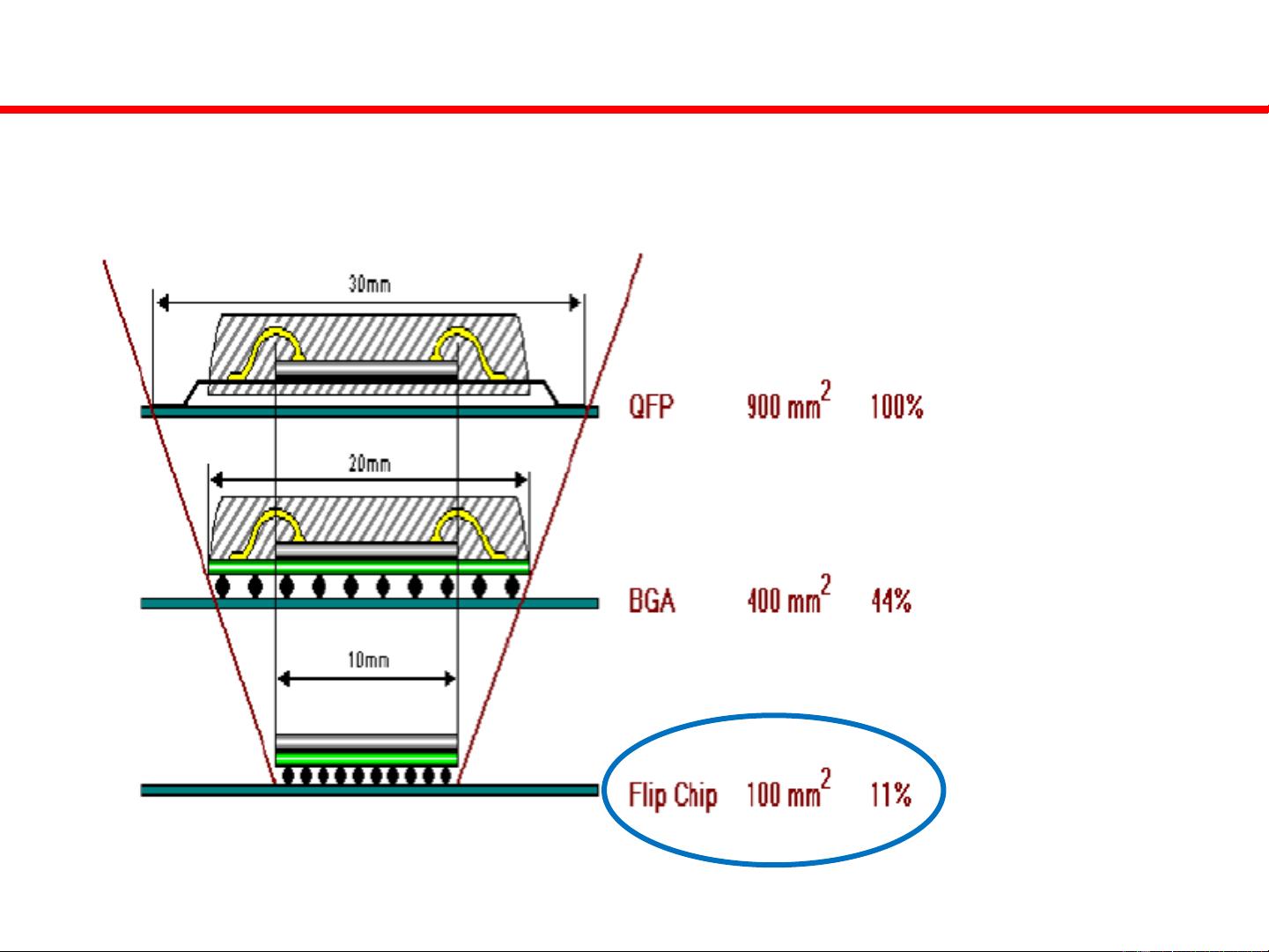
Why Bump Needed
Small outline size
Same chip size but much little package size with bump process.
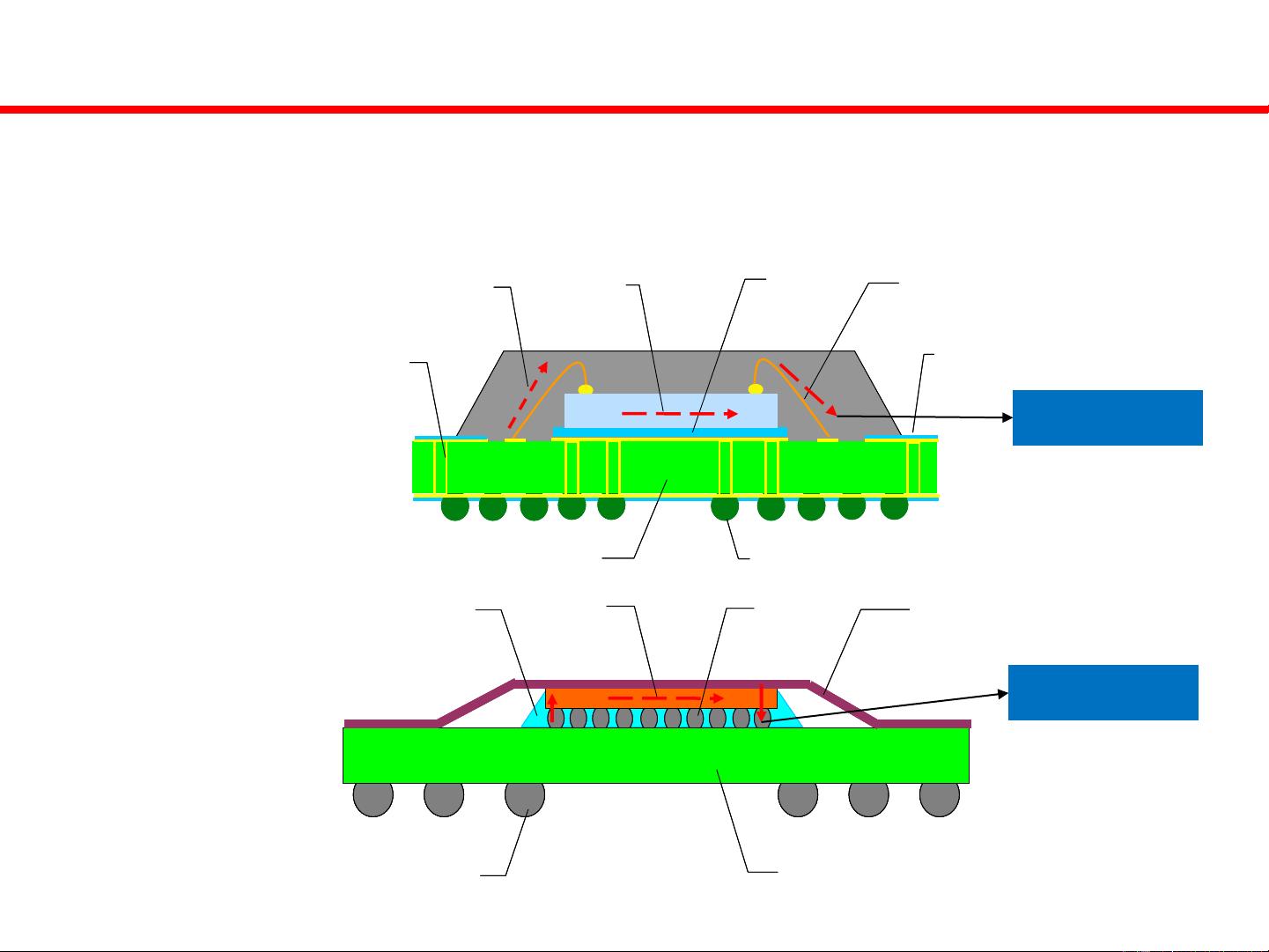
Why Bump Needed
Short signal path
Compared with wire bond, flip chip, which with bump process has shorter signal path.
Chip
Solder bump
Underfill
Heat spread
Substrate
Solder ball
Chip
Solder bump
Underfill
Heat spread
Substrate
Solder ball
signal path
Adhesive
Solder mask
Au wire
Die
Mold compound
Via
Solder ball
Substrate
Adhesive
Solder mask
Au wire
Die
Mold compound
Via
Solder ball
Substrate
signal path
Wire Bond
Flip Chip
剩余55页未读,继续阅读
资源评论

 weixin_414177592022-05-23用户下载后在一定时间内未进行评价,系统默认好评。
weixin_414177592022-05-23用户下载后在一定时间内未进行评价,系统默认好评。 树淼2022-10-31感谢资源主分享的资源解决了我当下的问题,非常有用的资源。
树淼2022-10-31感谢资源主分享的资源解决了我当下的问题,非常有用的资源。 m0_729770052022-08-02实在是宝藏资源、宝藏分享者!感谢大佬~
m0_729770052022-08-02实在是宝藏资源、宝藏分享者!感谢大佬~
pmsecapt
- 粉丝: 0
- 资源: 21
上传资源 快速赚钱
 我的内容管理
展开
我的内容管理
展开
 我的资源
快来上传第一个资源
我的资源
快来上传第一个资源
 我的收益 登录查看自己的收益
我的收益 登录查看自己的收益 我的积分
登录查看自己的积分
我的积分
登录查看自己的积分
 我的C币
登录后查看C币余额
我的C币
登录后查看C币余额
 我的收藏
我的收藏  我的下载
我的下载  下载帮助
下载帮助

 前往需求广场,查看用户热搜
前往需求广场,查看用户热搜安全验证
文档复制为VIP权益,开通VIP直接复制
 信息提交成功
信息提交成功

